
1、WLCSP是什么?
WLCSP(Wafer Level Chip Scale Package,晶圓級芯片級封裝)是一種先進的集成電路封裝技術,其特點是直接在晶圓上完成封裝,最終封裝尺寸接近芯片本身的大小。這種技術通過在晶圓上進行重新布線和凸點制造,實現高密度互聯和小型化封裝,廣泛應用于移動設備、消費電子和高性能計算領域。
2、WLCSP的分類?
扇入型晶圓級芯片封裝(Fan - In WLCSP):引腳從芯片四周引出,呈扇形引入到芯片底部,具有尺寸小、成本低、散熱性好等特點,但引腳數量較少,無法實現高集成度芯片封裝。
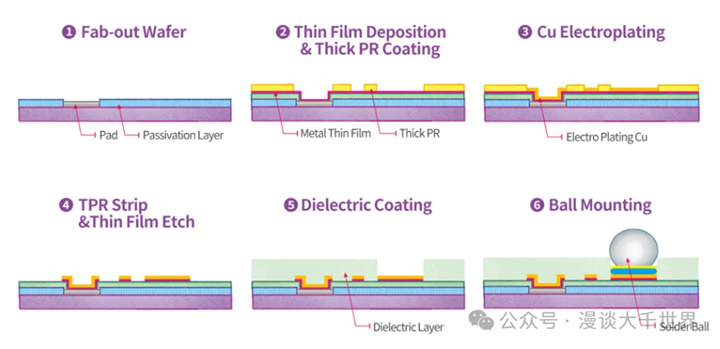
扇出型晶圓級芯片封裝(Fan - Out WLCSP):引腳從芯片底部引出,呈扇形引出到芯片外部,引腳數量多,電路設計靈活,能夠將多個芯片封裝為一體,在滿足小尺寸要求的同時可以實現更高集成度。
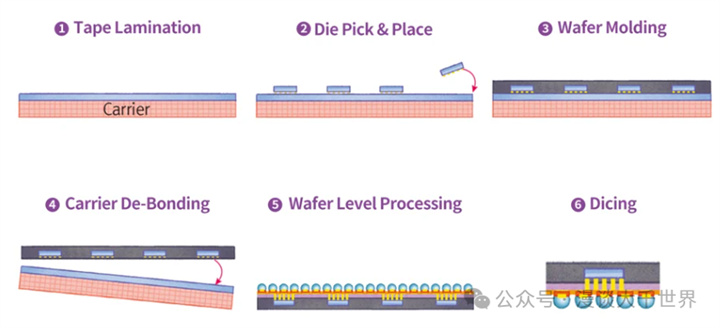
3、WLCSP工藝Flow
1. 晶圓準備
晶圓清洗:去除表面的顆粒、有機物和金屬殘留。
表面處理:通過化學或物理方法改善晶圓表面的附著性能。
2. 鈍化層沉積
在晶圓表面沉積一層鈍化材料(如SiO?或SiN),用于保護內部電路并提供絕緣。常用方法:PECVD(等離子體增強化學氣相沉積)。
3. 焊盤開窗
使用光刻技術在鈍化層上開窗,露出鋁焊盤。通過濕法蝕刻或干法蝕刻實現精確圖案化。
4. 重新布線(RDL, Redistribution Layer)
在晶圓表面制作重新布線層,將原本分散的小焊盤重新排列成更大的焊盤陣列。步驟如下,首先沉積導電材料(如銅或鋁),其次刻蝕形成所需的布線圖案,最后表面鈍化處理。
5. 凸點下金屬化(UBM, Under Bump Metallization)
在重新布線層的焊盤表面沉積一層或多層金屬薄膜,用于提高焊球與焊盤之間的粘附力和導電性。常見材料:Ti/Cu/Ni/Au。
6. 焊球植球
將焊球(如SnAgCu合金焊球)放置在重新布線層的焊盤上。焊球可以通過印刷法、電鍍法或回流焊接法固定。
7. 晶圓切割
使用激光切割或劃片機將封裝好的晶圓分割成單個芯片。注意保持切割路徑不會破壞芯片功能。
8. 成品測試
對切割后的單個芯片進行電氣性能測試和外觀檢查。測試內容包括導通性、絕緣性、焊球位置偏差等。
9. 最終封裝
將合格的芯片裝入最終的包裝載體中(如塑料封裝體或玻璃基板)。進行密封處理以防止外界環境的影響。




